www.mundonano.unam.mx | Mundo Nano
http://dx.doi.org/10.22201/ceiich.24485691e.2020.25.69636 | 13(25), 45-60, julio-diciembre 2020
Artículos de investigación
Resolución atómica de elementos ligeros utilizando HAADF y ABF-STEM con corrección de Cs y bajo voltaje*
Atomic resolution imaging of light elements using low voltage Cs-corrected HAADF and ABF-STEM
Rodrigo Esparza**
** Universidad Nacional Autónoma de México, Centro de Física Aplicada y Tecnología Avanzada, Boulevard Juriquilla 3001, Santiago de Querétaro, Qro., 76230, México. Correo electrónico: resparza@fata.unam.mx
Resumen:
La microscopía electrónica de barrido y transmisión (STEM) puede ofrecer información estructural y química con resolución espacial del orden de 0.1 nm, es posible alcanzar tal resolución utilizando un corrector de aberración esférica para el haz de prueba. En el STEM, un haz de electrones es enfocado y escaneado sobre la muestra, por lo que la imagen se forma midiendo la intensidad electrónica transmitida que surge después de las interacciones electrón-muestra. La intensidad de los electrones dispersados que atraviesan la muestra puede ser empleada para obtener imágenes de campo claro y campo obscuro. El microscopio STEM es un poderoso instrumento para estudiar las propiedades físicas de las nanoestructuras, que requieren de un análisis estructural y químico a nivel atómico. Por lo tanto, STEM es una técnica capaz de identificar columnas atómicas y la posición de los átomos auxiliándose con técnicas de simulación. En este trabajo, los parámetros instrumentales básicos del microscopio en modo campo oscuro anular de gran ángulo (HAADF-STEM) y campo claro (BF-STEM) fueron evaluados utilizando una muestra estándar de Si[110]. Además, imágenes experimentales de HAADF-STEM y campo claro anular (ABF-STEM) de una muestra de LaAlO3 se consiguieron a 80 kV de operación y comparadas con imágenes simuladas obtenidas con el método de multicapas, el cual se basa en la teoría dinámica de la difracción. Mediante la técnica ABF-STEM fue posible visualizar claramente las columnas atómicas de los elementos La, O y Al presentes en la muestra. Se encontró que las imágenes simuladas coinciden bien con las imágenes experimentales.
Palabras clave: microscopía electrónica de transmisión/barrido, campo oscuro anular de alto ángulo, campo claro anular, simulación de imágenes.
Abstract:
Scanning transmission electron microscopy (STEM) can give structural and chemical information down to 0.1 nm of spatial resolution, which sub-angstrom resolution is achieved with a spherical aberration corrector for the probe. In the STEM, the electron probe is focused and scanned over the sample and the image is formed by measuring the transmitted electron intensity arising after the electron-specimen interactions. The scattered electron intensity that cross the sample can be employed to obtain bright and dark field images. The STEM is a powerful instrument to understand the physical properties of nanostructures which requires the local structure and local chemistry to be determined at the atomic scale. Therefore, STEM is a technique able to identify the atomic columns and the position of atoms using simulation techniques. In this work, the basic instrumental parameters using high angle annular dark field (HAADF-STEM) and annular bright field (ABF-STEM) modes were evaluated using a standard sample of Si[110]. Also, experimental HAADF-STEM and annular bright field (ABF-STEM) images of LaAlO3 sample were obtained at 80 kV and compared with simulated images obtained by using the multi slice dynamical diffraction method. Using the ABF-STEM technique, it was possible to clearly visualize the atomic columns of the La, O and Al elements included in the sample. Images simulated were found to agree well with experimental images.
Keywords: scanning transmission electron microscopy, annular bright field, high angle annular dark field, image simulations.
Recibido: 20 de febrero de 2020.
Aceptado: 20 de mayo de 2020.
Introducción
El coeficiente de aberración esférica (Cs) ha sido el principal factor que restringe la resolución en el campo de la microscopía electrónica de transmisión (TEM). Sin embargo, la implementación del corrector de Cs en las últimas décadas ha incrementado el desarrollo de los microscopios electrónicos, alcanzando imágenes con una resolución por debajo de 0.1 nm. Aun más, los beneficios de la microscopía electrónica de barrido en transmisión (STEM) han sido mayores que los del TEM convencional, debido a la mejora en la relación señal/ruido, esto es posible gracias a la disponibilidad de un haz con mayor corriente (
Un STEM es un microscopio donde los electrones pasan a través de una muestra delgada, al igual que en un TEM. Sin embargo, el STEM se diferencia del TEM convencional por enfocar el haz de electrones en un punto que escanea la muestra, similar al microscopio electrónico de barrido (SEM). Usando el STEM y un detector anular de gran ángulo, es posible formar imágenes donde el contraste de estas está directamente relacionado con el número atómico de la muestra (
El STEM también ofrece importantes beneficios en imágenes en el modo campo oscuro anular de gran ángulo (HAADF-STEM). En este modo, el ángulo interno del detector anular se hace tan grande que no se recogen electrones difractados de Bragg. Las imágenes, por lo tanto, provienen de electrones dispersados incoherentemente que han pasado muy cerca de los núcleos atómicos de la muestra. Por consiguiente, imágenes con alta resolución son posibles sin contraste de difracción, el cual es no deseado dado que puede enmascarar información estructural. La señal de HAADF-STEM es directamente proporcional a la densidad y/o espesor de la muestra y proporcional a Zn, donde Z es el número atómico de los elementos de la muestra y el exponente n es cercano a 1.7. De este modo, es posible producir imágenes que muestren contraste debido a la combinación del espesor másico, donde la intensidad es proporcional al número de átomos e imágenes de contraste Z, donde la señal es proporcional al número atómico promedio de la muestra (
En el pasado, se favoreció el uso del TEM con altos voltajes porque en esas condiciones de operación se reducen los efectos de aberración cromática (Cc) y aumenta la resolución atómica debido a la disminución de la longitud de onda (
Como ejemplo de las aplicaciones del STEM, podemos mencionar la caracterización estructural de nanopartículas bimetálicas, tanto con una estructura del tipo núcleo-coraza como aleación. La morfología y estructura de las nanopartículas bimetálicas de AuPd se ha estudiado mediante la técnica de HAADF-STEM de alta resolución, donde las imágenes mostraron nanopartículas de Au con superficies enriquecidas con átomos de Pd (
Por otro lado, las imágenes obtenidas de campo claro anular (ABF) en STEM ha estimulado el interés de la investigación en los últimos años debido a su capacidad de una visualización directa de elementos ligeros (
El trabajo realizado en esta investigación está relacionado con la evaluación del rendimiento del instrumento STEM equipado con un corrector de Cs, para lo cual se utilizan muestras cristalinas de silicio (Si) orientadas a lo largo del eje de zona [110]. El STEM con aberración esférica corregida también se usó en la caracterización estructural de muestras de aluminato de lantano (LaAlO3) para la identificación de los elementos presentes en la muestra. Se llevaron a cabo comparaciones entre imágenes HAADF-STEM y ABF-STEM, así como simulaciones teóricas de imágenes de las muestras cristalinas.
Procedimiento experimental
Las condiciones instrumentales del microscopio electrónico Jeol JEM-ARM200F con un cañón de emisión de campo tipo Schottky se muestran en la Tabla 1. El voltaje de aceleración fue de 80 kV y una longitud de cámara de 80 mm. El microscopio está equipado con un corrector de aberración esférica (Cs) CEOS en el sistema de iluminación. El coeficiente de aberración esférica corregido es de aproximadamente 1 μm. Los ángulos de recolección para las técnicas de imagen HAADF y ABF se ajustaron en el rango de 90-170 mrad y 11-22 mrad, respectivamente. Además, se obtuvieron imágenes HAADF-STEM y BF-STEM de una muestra estándar de Si orientada a lo largo de la dirección [110], así como de una muestra de LaAlO3 (LAO).
Tabla 1. Valores de los coeficientes obtenidos para el STEM medidos a 80 kV, notación de Haider.
| Coeficientes | |
|---|---|
| Desenfoque C1 | -2.503 nm |
| Astigmatismo 2do. orden A1 | 1.722 nm |
| Coma B2 | 39.93 nm |
| Astigmatismo 3er. orden A2 | 77.01 nm |
| Aberración esférica C3 | 0.743 µm |
| Aberración Star S3 | 67.29 nm |
| Astigmatismo 4to orden A3 | 1.506 μm |
| Coma 5to orden B4 | 22.23 μm |
| Astigmatismo 5to orden A4 | 15.45 μm |
| Aberración esférica 5to orden C5 | -185.1 μm |
| Astigmatismo 6to orden A5 | 1.165 nm |
Fuente:
La preparación de las muestras de Si[110] y LAO se realizó mediante el uso de un microscopio de doble haz (FIB). El procedimiento general para la preparación de las muestras consta de cuatro etapas: depósito de una capa de platino, desbaste en las secciones laterales a la capa de platino, corte y extracción del material (lamela) el cual se pega a una rejilla de Cu, finalmente se adelgaza la muestra con un espesor menor a de 50 nm.
Los coeficientes de las aberraciones del STEM se midieron a 80 kV y fueron obtenidos después de la alineación del corrector mediante el programa del corrector CEOS (Tabla 1). Estos valores se consideraron para la simulación de las imágenes y el ronchigrama. Las simulaciones de las imágenes HAADF, BF y ABF-STEM se realizaron utilizando el programa QSTEM (
Resultados
Actualmente, la disponibilidad de los correctores de aberración para microscopios electrónicos de barrido en transmisión (STEM) es bastante amplia, aunque todavía son relativamente costosos (≈ 0.5 millones de US$). Estos instrumentos proporcionan una resolución espacial que se acerca a menos de 0.1 nm. Los correctores de aberración producen haces de electrones más pequeños y brillantes que permiten incluso obtener imágenes de un solo átomo (
La ruta más efectiva para alinear un STEM es mediante el uso del ronchigrama (
La Figura 1a muestra el ronchigrama experimental observado de una película de carbono amorfo obtenido a 80 kV y un coeficiente de aberración esférica Cs de 0.743 µm. Cabe mencionar que el carbono amorfo proviene de la membrana de soporte de una rejilla de Cu utilizada en microscopía de transmisión. El ronchigrama muestra un área plana coherente superior a 40 mrad en el ángulo medio, correspondiente al ángulo de convergencia de la fase uniforme (
Figura 1. a) Ronchigrama de una película de carbono amorfo obtenida a 80 kV y coeficiente de aberración esférica Cs = 0.743 µm; b) ronchigrama simulado usando los parámetros del instrumento; c) Cs = 500 µm; d) 1 mm, y, e) haz de electrones simulado con los coeficientes de aberración medidos durante el experimento, el haz de electrones tiene un FWHM de 0.15 nm.
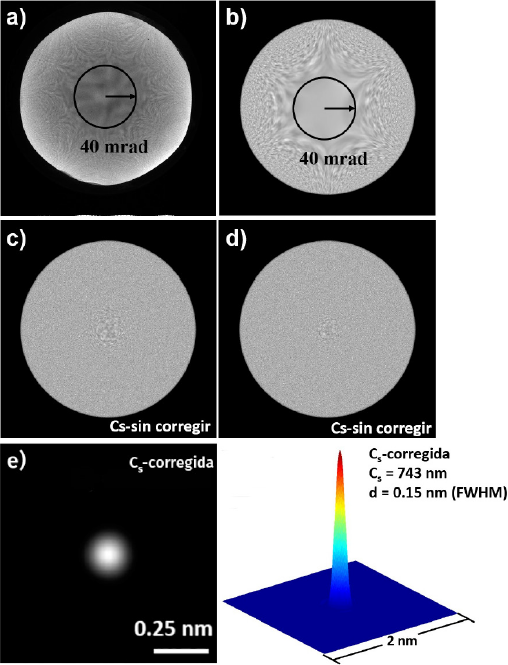
Fuente: Figura a) Cortesía del Kleberg Advanced Microscopy Center; b)-e) elaboración del autor.
La simulación del ronchigrama debe verse como una herramienta esencial para la comunidad que trabaja con STEM con aberración corregida. La Figura 1b muestra el ronchigrama simulado usando las mismas condiciones de operación del microscopio (véase la Tabla 1). Como se puede observar, el ángulo medio es del mismo tamaño que el ronchigrama experimental, además, no se observan franjas de interferencia en la región central del disco transmitido. Estas condiciones ópticas se utilizaron posteriormente en las simulaciones teóricas de las imágenes de STEM. Las Figuras 1c y d muestran los ronchigramas simulados utilizando como valor del coeficiente de aberración esférica 500 µm y 1 mm, respectivamente. Como se puede apreciar, en condiciones donde la aberración esférica no está corregida, no existe un área plana coherente. Es importante mencionar que una vez que se alinea el haz de electrones, se coloca una apertura de la lente condensadora en el centro del ronchigrama para obtener un haz de electrones fino y con alta intensidad. Utilizando el STEM con el corrector de Cs, se pueden obtener imágenes simultáneas con alta resolución de las posiciones de los átomos pesados y ligeros, incluso en condiciones de contraste Z (
Con el fin de evaluar las condiciones experimentales del microscopio, se obtuvieron imágenes de campo oscuro anular de alto ángulo (HAADF)-STEM y de campo claro (BF)-STEM de estándares de Si a lo largo de la dirección [110]. Las Figuras 2a y 2b muestran las imágenes de HAADF-STEM y BF- STEM obtenidas de la muestra de Si orientada a lo largo de la dirección [110]. En las imágenes, se incluye un recuadro relacionado con la simulación teórica de cada imagen. La simulación de las imágenes se basa en el método multicapas de la teoría dinámica de la difracción de electrones (
Figura 2. a) HAADF-STEM y b) BF-STEM imágenes de Si[110] tomadas a 80 kV, las imágenes muestran una resolución espacial de 0.09 nm.
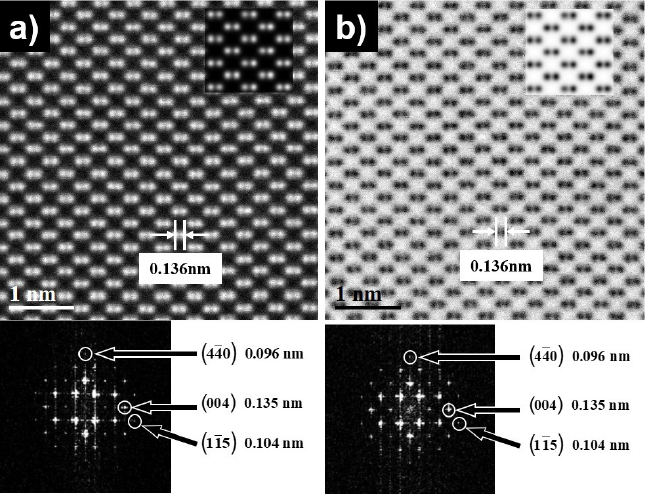
Fuente: Imágenes cortesía del Kleberg Advanced Microscopy Center; recuadros y FFT, elaboración del autor.
Campo claro anular en STEM (ABF-STEM) es una técnica de imagen propuesta hace décadas y utilizada cada vez con mayor frecuencia. La técnica consiste en un detector de campo claro (BF-STEM) en el que el área central queda obstruida -puede hacerse con el bloqueador del haz (beam stopper) del microscopio-, con la finalidad de producir imágenes que muestran columnas de elementos ligeros y pesados (
Figura 3. a) Configuración del STEM; b) configuración para obtener imágenes ABF-STEM; c) ronchigrama con las aperturas de campo claro y el bloqueador del haz, y, d) detalle de la apertura de campo claro y el bloqueador del haz.

Fuente: a) y b) adaptado de (
Para comprobar la configuración anterior, las Figuras 4a y b muestran las imágenes experimentales de HAADF-STEM y ABF-STEM, respectivamente, de la fase LaAlO3 (LAO) que tiene una estructura cúbica y un grupo espacial Pm-3m (221), con lantano (La) en las esquinas, aluminio (Al) en el centro y tres átomos de oxígeno (O) en los centros de las caras. A partir de las imágenes experimentales, se obtuvieron distancias interplanares de 0.382, 0.268, 0.191 y 0.171 nm. Dichas distancias interplanares corresponden a los planos cristalinos (001), (011), (002) y (012), respectivamente, de la estructura del LAO con a0 = 0.3812 nm, y orientada en el eje de zona [001] (ICDD JCPDF 01-070-4123) (
Figura 4. a) y b) imágenes de HAADF y ABF-STEM de la fase LaAlO3 a lo largo del eje de zona [001]; c) diferentes perfiles de intensidad obtenidos de las imágenes STEM.
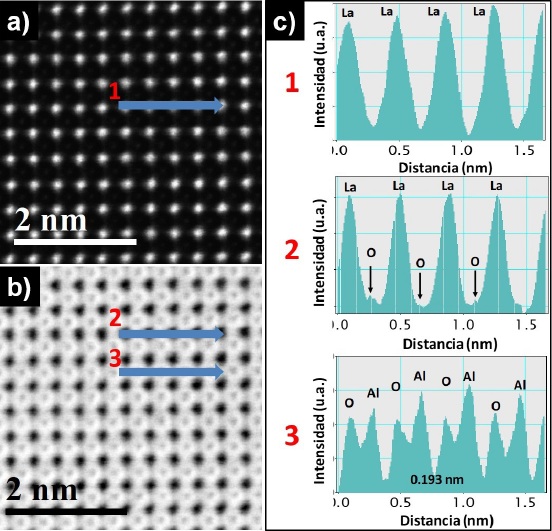
Fuente: Elaboración del autor.
La imagen de HAADF-STEM muestra una secuencia de puntos muy brillantes, estos puntos brillantes corresponden a la contribución de las columnas de La, dado que La tiene un número atómico mayor que Al y O (57, 13 y 8, respectivamente), de modo que la contribución de dispersión de los átomos de Al y O es muy débil. Imágenes de HAADF-STEM obtenidas de interfaces de LaAlO3/Si y BiFeO3/LaAlO3 han sido reportadas previamente, donde la intensidad de las columnas Al-O de la fase LAO aparecen débiles en comparación con las columnas de La, como lo mostrado en este trabajo, así como también que las columnas de O no contribuyen significativamente al contraste de la imagen (
Para comparar la intensidad de las diferentes columnas atómicas, se obtuvieron perfiles de intensidad de ambas imágenes. La Figura 4c muestra los perfiles de intensidad realizados a lo largo de las líneas indicadas en las Figuras 4a y b. A partir de los perfiles de intensidad, está claro que hay picos con diferente intensidad, lo cual refleja el contraste Z de las columnas atómicas. El perfil de intensidad etiquetado con el número 1 es obtenido de la imagen HAADF-STEM, este perfil solo muestra la contribución de los átomos de La como se esperaba. Los perfiles etiquetados como números 2 y 3 se obtuvieron de la imagen ABF-STEM, por lo tanto, se pueden observar elementos ligeros como el Al y O, así como el La. El perfil etiquetado con el número 2 muestra la contribución de La, que son los picos de mayor intensidad, y también se muestran algunos picos con baja intensidad, que están asociados con O. Es interesante observar en este perfil de intensidad las columnas atómicas de O, que en la imagen de HAADF-STEM no se apreciaban. El perfil de intensidad etiquetado con el número 3 muestra claramente la contribución del Al y O, con una buena relación señal/ruido. Por consiguiente, la técnica ABF-STEM mejora el contraste de las columnas atómicas de elementos ligeros y se puede emplear con éxito para detectar la posición de los elementos ligeros en los materiales.
La simulación de las imágenes ABF y HAADF-STEM se realizó utilizando el programa QSTEM (
Figura 5. a) y b) Imágenes simuladas de HAADF y ABF-STEM de la fase LaAlO3; c) perfiles de intensidad a través de las imágenes experimentales y simuladas de ABF-STEM.

Fuente: Elaboración del autor.
Conclusiones
Se evaluó el rendimiento del STEM equipado con un corrector de Cs. Las aberraciones axiales de un sistema de lentes formadoras del haz de electrones son directamente visibles en un ronchigrama, por lo cual se considera como parte fundamental del procedimiento de alineación de los correctores de aberración disponibles en un STEM. La efectividad de la metodología de simulación propuesta demostró una comparación entre los ronchigramas experimentales y simulados obtenidos con los parámetros del instrumento con un ángulo medio superior a 40 mrad. Las transformadas rápidas de Fourier obtenidas de las imágenes de STEM de Si[110] tomadas con un voltaje de aceleración de 80 kV muestran una resolución espacial de hasta 0.09 nm. STEM con corrección de Cs visualiza con precisión la estructura atómica tanto de elementos ligeros como de pesados, obteniendo imágenes simultáneas de ABF-STEM y HAADF-STEM controlando los ángulos de recolección del detector circular BF y del detector anular ADF, respectivamente. Las condiciones experimentales para visualizar las columnas atómicas de la muestra LaAlO3 fueron para ABF 11-22 mrad y para HAADF con 90-170 mrad. Mediante la técnica ABF-STEM se demostró que se pueden detectar tanto elementos ligeros como pesados en las redes cristalinas, en este caso fue posible visualizar las columnas atómicas del La, Al y O presentes en la muestra LAO. Las simulaciones de las imágenes de ABF-STEM y HAADF-STEM basadas en el método multicapas de Cowley y Moodie se han utilizado como herramienta para identificar el contraste de las diferentes columnas atómicas. ABF-STEM, es una técnica que mejora el contraste de las columnas atómicas y puede emplearse para la detección de elementos ligeros de diversos materiales.
Referencias
- Barthel, J. (2007). http://www.er-c.org/barthel/drprobelight/
- Bell, D. C., C. J. Russo y D. V. Kolmykov. (2012). 40 keV atomic resolution TEM. Ultramicroscopy, 114: 31-37. https://doi.org/10.1016/j.ultramic.2011.12.001
- Benetatos, N. M., B. W. Smith, P. A. Heiney y K. I. Winey. (2005). Toward reconciling STEM and SAXS data from ionomers by investigating gold nanoparticles. Macromolecules, 38: 9251-9257. https://doi.org/10.1021/ma051419i
- Cowley, J. M. (1986). Electron diffraction phenomena observed with a high resolution STEM instrument. Journal of Electron Microscopy Technique, 3: 25-44. https://doi.org/10.1002/jemt.1060030105
- Cowley, J. M. y A. F. Moodie. (1957). The scattering of electrons by atoms and crystals. I. A new theoretical approach. Acta Crystallographica, 10: 609-619. https://doi.org/10.1107/S0365110X57002194
- Crewe, A. V., J. Wall y J. Langmore. (1970). Visibility of single atoms. Science, 168 (3937): 1338-1340. https://doi.org/10.1126/science.168.3937.1338
- Dupouy, G. (2017). Chapter four - Electron microscopy at very high voltages. En Advances in Imaging and Electron Physics. Elsevier, 261-340.
- Dwyer, C. (2010). Simulation of scanning transmission electron microscope images on desktop computers. Ultramicroscopy, 110(3): 195-198. https://doi.org/10.1016/j.ultramic.2009.11.009
- Esparza, R., A. F. García-Ruiz, J. J. Velázquez Salazar, R. Pérez y M. J. Yacamán. (2013). Structural characterization of Pt-Pd core-shell nanoparticles by Cs-corrected STEM. Journal of Nanoparticle Research, 15(1): 1342. https://doi.org/10.1007/s11051-012-1342-2
- Esparza, R., O. Téllez-Vázquez, G. Rodríguez-Ortiz, A. Ángeles-Pascual, S. Velumani y R. Pérez. (2014). Atomic structure characterization of Au-Pd bimetallic nanoparticles by aberration-corrected scanning transmission electron microscopy. The Journal of Physical Chemistry C, 118(38): 22383-22388. https://doi.org/10.1021/jp507794z
- Findlay, S. D., N. Shibata, H. Sawada, E. Okunishi, Y. Kondo, T. Yamamoto y Y. Ikuhara. (2009). Robust atomic resolution imaging of light elements using scanning transmission electron microscopy. Applied Physics Letters, 95: 191913. https://doi.org/10.1063/1.3265946
- Garcia, A., A. M. Raya, M. M. Mariscal, R. Esparza, M. Herrera, S. I. Molina, G. Scavello, P. L. Galindo, M. J. Yacamán y A. Ponce. (2014). Analysis of electron beam damage of exfoliated MoS2 sheets and quantitative HAADF-STEM imaging. Ultramicroscopy, 146: 33-38. https://doi.org/10.1016/j.ultramic.2014.05.004
- Geuens, P. y D. Van Dyck. (2003). About forbidden and weak reflections. Micron, 34: 167-171. https://doi.org/10.1016/S0968-4328(03)00032-5
- Haider, M., S. Uhlemann y J. Zach. (2000). Upper limits for the residual aberrations of a high-resolution aberration-corrected STEM. Ultramicroscopy, 81(3-4): 163-175. https://doi.org/10.1016/S0304-3991(99)00194-1
- Haider, M., P. Hartel, H. Müller, S. Uhlemann y J. Zach. (2009). Current and future aberration correctors for the improvement of resolution in electron microscopy. Philosophical Transactions of the Royal Society A, 367: 3665-3682. https://doi.org/10.1098/rsta.2009.0121
- Haider, M., S. Uhlemann, E. Schwan, H. Rose, B. Kabius y K. Urban. (1998). Electron microscopy image enhanced. Nature, 392(6678): 768-769. https://doi.org/10.1038/33823
- Hawkes, P. W. (2004). Advances in imaging and electron physics: Elsevier.
- Huang, R., H. C. Ding, W. I Liang, Y. C. Gao, X. D. Tang, Q. He, C. G. Duan, Z. Zhu, J. Chu, C. A. J. Fisher, T. Hirayama, Y. Ikuhara y Y. H. Chu. (2014). Atomic scale visualization of polarization pinning and relaxation at coherent BiFeO3/LaA-lO3 interfaces. Advanced Functional Materials, 24(6): 793-799. https://doi.org/10.1002/adfm.201301470
- James, E. M. y N. D Browning. (1999). Practical aspects of atomic resolution imaging and analysis in STEM. Ultramicroscopy, 78: 125-139. https://doi.org/10.1016/S0304-3991(99)00018-2
- Jones, L., K. E. MacArthur, V. T. Fauske, A. T. J. van Helvoort y P. D. Nellist. (2014). Rapid estimation of catalyst nanoparticle morphology and atomic-coordination by high-resolution Z-contrast electron microscopy. Nano Letters, 14: 6336-6341. https://doi.org/10.1021/nl502762m
- Kirkland, E. J., R. F. Loane y J. Silcox. (1987). Simulation of annular dark field stem images using a modified multislice method. Ultramicroscopy, 23: 77-96. https://doi.org/10.1016/0304-3991(87)90229-4
- Klenov, D. O., D. G. Schlom, H. Li y S. Stemmer. (2005). The interface between single crystalline (001) LaAlO3 and (001) silicon. Japanese Journal of Applied Physics, 44 (5L): L617. https://doi.org/10.1143/JJAP.44.L617
- Klie, R. F. y Y. Zhu. (2005). Atomic resolution STEM analysis of defects and interfaces in ceramic materials. Micron, 36(3): 219-231. https://doi.org/10.1016/j.micron.2004.12.003
- Koch, C. (2002). Determination of core structure periodicity and point defect density along dislocations. USA: Arizona State University.
- Kotaka, Y. (2012). Direct visualization method of the atomic structure of light and heavy atoms with double-detector Cs-corrected scanning transmission electron microscopy. Applied Physics Letters, 101(13): 133107. https://doi.org/10.1063/1.4756783
- Lee, P. W., V. N. Singh, G. Y. Guo, H.-J. Liu, J.-C. Lin, Y.-H. Chu, C. H. Chen y M.-W. Chu. (2016). Hidden lattice instabilities as origin of the conductive interface between insulating LaAlO3 and SrTiO3. Nature Communications, 7: 12773. https://doi.org/10.1038/ncomms12773
- Maurice, J. L., C. Carrétéro, M. J. Casanove, K. Bouzehouane, S. Guyard, É. Larquet y J. P. Contour. (2006). Electronic conductivity and structural distortion at the interface between insulators SrTiO3 and LaAlO3. Physica Status Solidi, 203(9): 2209-2214. https://doi.org/10.1002/pssa.200566033
- Mayoral, A., R. Esparza, F. L. Deepak, G. Casillas, S. Mejía-Rosales, A. Ponce y M. J. Yacamán. (2011). Study of nanoparticles at UTSA: one year of using the first JEM-ARM200F installed in USA. Jeol News, 46 (1): 1-5.
- Mishra, R., R. Ishikawa, A. R. Lupini y S. J. Pennycook. (2017). Single-atom dynamics in scanning transmission electron microscopy. MRS Bulletin, 42(9): 644-652. https://doi.org/10.1557/mrs.2017.187
- Okunishi, E., I. Ishikawa, H. Sawada, F. Hosokawa, M. Hori y Y. Kondo. (2009). Visualization of light elements at ultrahigh resolution by stem annular bright field microscopy. Microscopy and Microanalysis, 15(S2): 164-165. https://doi.org/10.1017/S1431927609093891
- Pennycook, S. J., D. E. Jesson, A. J. McGibbon y P. D. Nellist. (1996). High angle dark field STEM for advanced materials. Microscopy, 45(1): 36-43. https://doi.org/10.1093/oxfordjournals.jmicro.a023410
- Rodenburg, J. M. y E. B. Macak. (2002). Optimising the resolution of TEM/STEM with the electron ronchigram. Microscopy and Analysis, 5-7.
- Rodríguez-Proenza, C. A., J. P. Palomares-Báez, M. A. Chávez-Rojo, A. F. García-Ruiz, C. L. Azanza-Ricardo, A. Santoveña-Uribe, G. Luna-Bárcenas, J. L. Rodríguez-López y R. Esparza. (2018). Atomic surface segregation and structural characterization of PdPt bimetallic nanoparticles. Materials, 11(10): 1882. https://doi.org/10.3390/ma11101882
- Sasaki, T., H. Sawada, F. Hosokawa, Y. Kohno, T. Tomita, T. Kaneyama, Y. Kondo, K. Kimoto, Y. Sato y K. Suenaga. (2010). Performance of low-voltage STEM/TEM with delta corrector and cold field emission gun. Journal of Electron Microscopy, 59(S1): S7-S13. https://doi.org/10.1093/jmicro/dfq027
- Sawada, H., T. Sannomiya, F. Hosokawa, T. Nakamichi, T. Kaneyama, T. Tomita, Y. Kondo, T. Tanaka, Y. Oshima, Y. Tanishiro y K. Takayanagi. (2008). Measurement method of aberration from ronchigram by autocorrelation function. Ultramicroscopy, 108(11): 1467-1475. https://doi.org/10.1016/j.ultramic.2008.04.095
- Spence, J. C. H. (2013). High-resolution electron microscopy. OUP Oxford.
- Zhou, D., K. Müller-Caspary, W. Sigle, F. F. Krause, A. Rosenauer y P. A. van Aken. (2016). Sample tilt effects on atom column position determination in ABF-STEM imaging. Ultramicroscopy, 160: 110-117. https://doi.org/10.1016/j.ultramic.2015.10.008
Notas:
* R. Esparza agradece al Kleberg Advanced Microscopy Center de la UTSA por sus instalaciones.